

|
|
Главная -> Магнитоэлектроника 0 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 [18] 19 20 21 22 23 24 25 26 27 28 базы могут быть созданы S-области с повышенной скоростью ре- комбинашш. т., „ На рис. 4.16 приведено семейство ВАХ база - база симметричного однопереходного магнитотранзистора. Инжекцию носителей можно создать и из какого-либо базового контакта. В такой конструкции (рис. 4.15,6) основным зависящим от магнитного поля параметром будет f/вкл. Инжектированные из прямосмещен-ного базового р-«-перехода (Б2), носители заряда будут достигать центрального р-«-перехода и изменять его ток насыщения. Если переход включен в обратном направлении, то его ток полностью определится концентрацией дошедших до него неосновных носителей, инжектированных из базового р-«-перехода. Инжекцией из базового р-«-перехода можно модулировать сопротивление нижней части базы, тем самым уменьшая f/вкл- В магнитном поле, отклоняющем инжектированные из базового р-«-перехода носители к области с высокой скоростью рекомбинации, исходное сопротивление базы растет, что приводит к увеличению Ивкл- В противоположном направлении магнитного поля f/вкл уменьшается. 4.6. ПОЛЕВЫЕ ГАЛЬВАНОМАГНИТОРЕКОМБИНАПИОННЫЕ МАГНИТОТРАНЗИСТОРЫ Полевой гальваномагниторекомбинаиионный (ПГМР) магнитотранзистор [50] состоит из полупроводниковой пластины /, проводимость которой близка    Рис. 4.17. Полевой гальваномагниторекомбинационный магнитотранзистор со м?,п17»РдГч " МДПДМ (б); схемы включения для МДП (в) и МДПДМ (г) соответственно к собственной (рис 4.17,0), и одного-двух металлических полевых электродов 4 для подвода управляющего напряжения, изолированных слоями диэлектрика 3. На торнах пластины расположены токовые электроды 2, 5. Магнитотранзнстор ПГМР имеет МДП-структуру. Существует и другая структура магнитотранзистора: металл - диэлектрик - полупроводник - диэлектрик - металл (МДПДМ) (рис. 4.17,6), в которой управляющее напряжение подводится к обоим полевым электродам. В основе действия ПГМР магнитотранзистора с МДП-струк-турой лежит изменение средней концентрации носителей заряда в полупроводнике при воздействии магнитного поля, продольного и поперечного электрических полей. Если ПГМР магнитотранзнстор поместить в магнитное поле так, чтобы магнитные силовые линии были перпендикулярны продольной составляющей электри- Таблица 4.1
Примечание. Диапазон температур 220-330 К. Температурный коэффициент магниточувствительности 0,27п/К. Коэффициент нелинейности характеристики передачи iO-.S-A ческого тока и приложить к электродам управляющее напряжение, то произойдет перераспределение концентрации носителей заряда по сечению пластины в направлении действия сил Лоренца. При этом Е зависимости от разности скоростей поверхностной 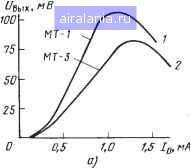
Рис. 4.18. Зависимость выходного напряжения ПГМР магнитотранзисторов со структурой МДП (/) и МДПДМ (2) от тока питания при В=1 мТл (о) и от магнитной индукции при /р=0,8 мА (б) рекомбинации на гранях пластины, где расположены полевые электроды и направления сил Лоренца происходит уменьшение ти увеличение концентрации носителей по сравнению с равновесной Это приводит к возрастанию или уменьшению сопротивления ПГМР магнитотранзистора. В табл. 4.1 приведены основные характеристики ПГМР магнитотраизисторов на основе германия, изготавливаемых в Институте физики полупроводников АН ЛитССР [50]. На рис. 4.18 приведены зависимости выходного напряжения ПГМР магнитотраизисторов от тока и магнитной индукции. Эти магнитотранзисторы обладают линейной характеристикой передачи. Использование ПГМР магнитотраизисторов особенно эффективно при построении измерителей магнитных величин с автоматической коррекцией погрешностей или аналого-цифровым преобразованием входной магнитной величины, различных магнитных и электрических регуляторов устройств автоматики и управления с переменной или адаптируемой структурой. 4.7. МАГНИТОТИРИСТОРЫ Любой тиристор можно представить в виде эквивалентной схемы, состоящей из двух транзисторов, поэтому магниточувстви-тельные свойства тиристоров характеризуются магниточувстви-тельными свойствами составляющих транзисторов [7]. Напряжение включения тиристора выражается через коэффициенты передачи по току Л", и двух транзисторов [7, 51] екл = и„ 1-Л,(1+у/ек,)-Л, . где Un - напряжение лавинного пробоя коллекторного р-п-перехода; /вкл -ток включения; /у - ток управления; с = 2-6. Выпускаемые в настоящее время тиристоры .в основном изготавливаются методом двойной диффузии. Длина базы п-р-п-транзисто-ра в структуре достаточно тонкая, и /г, в поперечном магнитном поле практически не изменяется. Длина базы второго р-п-р-транзистора порядка Lp, поэтому в магнитном поле меняется значительно сильнее /г, . Площадь коллектора обычно велика, и эффекта отклонения инжектированных носителей заряда от коллектора не наблюдается, поэтому изменение /г,, определяемое только изменением эффективной длины базы, небольшое. В таких тиристорах f/вкл относительно слабо зависит от магнитного поля.- Для увеличения магниточувствительности необходимо обеспечить более сильную зависимость /г, от индукции магнитного поля. Этого можно достичь использованием эффекта отклонения инжектированных носителей заряда от коллектора. Наиболее удобной конструкцией, обеспечивающей эти условия, является обычный планарный тиристор, на поверхности «длинной» базы которого имеется 5-область с повышенной скоростью рекомбинации неосновных носителей заряда 60 0 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 [18] 19 20 21 22 23 24 25 26 27 28 0.0066 |