

|
|
Главная -> Конструктирование оптикоэлектронной аппаратуры 0 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 [25] 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78  Рис. 3.11. Зависимости квантового выхода Т1внут N соединения pGaAsi-xPx от концентрации дырок р при Тп,=тм = 10- с и следующих значениях концентрации азота (и состава): / -2-10" см-= (0,5); 2 - 6-10" см- (0,6); 3 - 9-10" CM- (0,7); 4 -1,3-10» см-МО.8); 5-1.6-10" CM-S (0,9); 6 -г-Ю" см- (1.0) Рис. 3.12. Зависимости оптимальной концентрации дырок в pGaAsj-xPi и электронов в п GaAsi-Px : N от Лтп. при х: / - 0,5; 2-0.6; 3-0,7; 4 - 0.8; 6 - 0,9; 6-1.0 Результаты расчета tibhvtn в зависимости от Tps показывают, что TjEHyxN уменьшается и Пот смещается в сторону меньших значений при всех составах; в nGaP, например, Поптб-Ю см-, что очень близко к экспериментальному значению ПоптЗ-10® см-з при Tps=3,5-I0- с [83]. В обобщенном виде зависимости т1внут(л:) при оптимальной концентрации дырок (р-ТИП) или электронов (П-ТИП) и Tns(Tps) = =I0-... ю- с для системы GaAsi-Ppc представлены на рис. 3.13. Хорошо видно, ЧТО если безызлучательная рекомбинация с участием мелких доноров отсутствует, то при малых значениях xns, Tps и л:<0,8 в рассматриваемом случае может быть получен больший внутренний квантовый выход в полупроводниках р-типа {гъуты). Вицт N Рис. 3.13. Зависимости от внутреннего квантового выхода Т1внут к в GaAsj 5cP3c: N от состава при Т= =300 К, оптимальной концентрации дырок (кривые J, 3) и электронов (кривые 2, 4), времени Tn»=Tps= = 10- с (кривые /. 2) и 10- с (кривые 3, 4) 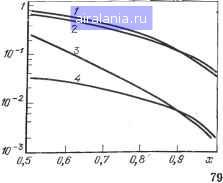 чем в полупроводниках п-типа (т1"внут). Если присутствие мелких доноров уменьшает Tps, то тем более твнут №>г]"внут w - на рис. 3.13 это хорошо видно из сравнения кривых 3 к 4. В некомленсированных твердых растворах р-типа Xns слабо зависит от Na- При фиксированной величине хм присутствие мелких компенсирующих доноров может приводить к уменьшению Xns и к смещению ропт в сторону больших значений. В компенсированных полупроводниках зависимость Xns от концентрации безызлучательных центров, включающих компенсирующие доноры, описывается формулой \ yndNd Для GaP в § 2.5 приведены следующие экспериментальные данные: a„d=7-10-5 см2, NalO-Nn. Уменьшение Xns, вызванное присутствием компенсирующих доноров, приводит к соответствующему уменьшению riBHyrN- Например, присутствие доноров (Nd=W см") в pGaP приводит к уменьшению максимального значения г]внутк на порядок. Из всего изложенного следует основной вывод: по величине /оуд СИД с выращенным р-п переходом в принципе должны превосходить СИД с диффузионным р-п переходом, так как во втором случае р-область по необходимости является компенсированной. Если известны состав, концентрация азота и может быть проведена количественная оценка величины хм, определяемой качеством исходных материалов и уровнем технологии, то, как следует из настоящего анализа, могут быть вычислены значения Ропт и Попт и, следовательно, теоретически предсказаны оптимальные значения Na в р-области в N в п-области СИД. В заключение проведем такую оценку для СИД из GaP с выращенным р-п переходом. Допустим, что хм контролируется только плотностью линейных дислокаций pd. Реалистическая оценка тм, на наш взгляд, такова: хмпОр 10 с (здесь DDnxDp = = 3 CM-c-i, pd»;3-i]0* см-2). В этом случае по формулам (3.23) и (3.24) находим Лл= (3... 10)-Ю cм- iVA = 4-10i см- и Т1"внут N Т]Рвнут N 10% . Аналогичная оценка для СИД из GaAso.isPo.ss: N с диффузионным р-п переходом и такими же значениями D и pd приводит к Т1"внутЫ» 10% и Г]РвнутЛ; 15%. В соответствии с многопараметрической моделью светоизлу-чающего кристалла перейдем теперь к вопросу оптимизации параметров с точки зрения достижения максимального значения Ivyp,. Рассмотрим вначале кристалл типа I с выращенным р-п переходом на основе GaP: N. Исходные положения для этого случая можно сформулировать следующим образом: 1. Излучение генерируется как в р-, так и в п-области кристалла, внутренний квантовый выход Т1"в„уты и цРиут описывается формулами (3.23) и (3.24). 80 2. Кристалл представляет собой длинный диод (L„/tfp<Cl; i Ljujdnl) с резким р-п переходом и тонкой областью объемного заряда. 3. Кристалл имеет плоскую конструкцию. На первой стадии расчета пренебрегаем многократным отражением излучения внутри кристалла, т. е. при выводе излучения в воздух в направлении, перпендикулярном плоскости р-п перехода, считаем 2=0,0173 и йз=1. Переизлучение не учитываем (П=1). Времена жизни Хп и Хр, необходимые для расчета коэффициентов инжекции Ki и /C"i, описываются соотношениями Тр - Tpg ps При этом излучательное тяе и безызлучательное XNe времена жизни даются соответственно формулами (2.22) и (2.23). В основном величины Хп и хр определяются каналами безызлучательной рекомбинации (времена Xns и Xps), шунтирующими рекомбинацию экситонов, связанных на изоэлектронных центрах азота. Будем считать, что, как и в прямозонных твердых растворах, основными шунтирующими каналами являются рекомбинации на дислокациях и на центрах, включающих мелкие легирующие доноры {DX-центры). В рассматриваемом случае доноры присутствуют только в п-слое. Время жизни xps описывается формулой -=Л1 (l+ =KDpp,(l + KDpp,VpdA/bx)-. (3.26) время жизни Xns - формулой В качестве легирующей примеси выберем Те или Se как наиболее мелкие доноры. Примем следующие значения параметров: тм=10- и 10- с, что соответствует рй»2-10 и 2-10 см; Трйб-Ю-" см-с"*. Значения Dp при заданном Nd рассчитывались с использованием рис. 3.3. Концентрация азота Л/ы=2-10з см~2. Теоретические зависимости /уд от No при различных значениях Na в р-области приведены на рис. 3.14. Абсолютный максимум /суд соответствует Na=10" см и Nd=1-W см.-. При дальнейшем увеличении Nd удельная сила света практически не изменяется. Таким образом, оптимальной концентрацией доноров является NnlO" си~, так как с дальнейшим увеличением Nd растет вероятность загрязнения р-слоя неконтролируемыми донорами в процессе выращивания структуры и соответственно снижения i-jJBHyTN И /суд. Параллельно с увеличением /суд три конструировании кристалла необходимо решать задачу получения омического контакта к р-слою с малым удельным сопротивлением. 0 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 [25] 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78 0.0118 |